|
等离子体增强化学气相沉积(PECVD)也就是等离子体增强化学气相沉积法,是目前最主要的化学沉积系统。AP CVD和LPCVD是按照气压进行分类的化学气相沉积法,而化学气相沉积(PECVD)是按照反应激活能来进行定义的。在化学气相沉积(CVD)中,不仅可以利用热能来激活和维持化学反应,也可以通过非热能源的射频(RF)等离子体来激活和维持化学反应,而且受激活的分子可以在低温下发生化学反应,所以沉积温度不仅比APCVD和LPCVD系统低,而且还具有更高的沉积速率。
物理化学气相沉积是借助微波或射频等使含有薄膜组成原子的气体电离,在局部形成等离子体,而等离子体的化学活性很强,很容易发生反应,在衬底上沉积出所需要的薄膜。为了能使化学反应在较低的温度下进行,利用等离子体的活性来促进反应进行因此这种化学气相沉积(CVD)系统又称为等离子体增强化学气相沉积(PECVD)。
低温沉积是物理化学气相沉积(PECVD)的一个突出优点。因此,可以在铝上沉积二氧化硅。PE CVD沉积的薄膜具有良好的附着性、针孔密度低、台阶覆盖率好、电学特性优良、可以与精细图形转移工艺相兼容,这些优良的特性使PECVD在ULSI工艺中得到广泛的应用。
PECVD在藩膜沉积过程中,使用等离子体能量来产生并维持CVD反应。PECVD的系统反应压强和LP CVD系统的反应压强差距不大,因此,PECVD的发展是紧随着LPCVD的发展而发展的。不同的是,PECVD的反应温度远远低于LPCVD的反应温度。例如,LP CVD沉积氮化硅(Si3N4)的温度一般是800“C~900℃℃,而铝的熔点是660C,
因此,不能用LPCVD系统在铝上沉积氨化硅,而采用沉积温度为350℃的PECVD系
统就可以达到在铝上沉积氨化硅的工艺目的。PECVD的基本结构为两个金属电极板,在其中的一个金属板上施加13.56MHz的射频电源,利用交流电让两个金属极板之间的自由电子产生振荡,振荡电子撞击反应气体使气体原子或分子形成游离态,反复振荡产生大量的活性游离基。由碰撞而产生的高能量的活性基是化学反应的主要来源。高能电子和离子复合产生辉光是形成等离子体的一个明显表征。PECVD基本结构如图7-14所示。

PECVD基本结构示意图
图(a)为电容耦合结构,平行板放射状反应结构:图(b)为电容耦合,平行板管式反应结构;图(c)为电感耦合垂直反应结构:图(d)为电感耦合水平反应结构。图7-15所示为PECVD系统的结构示意图。
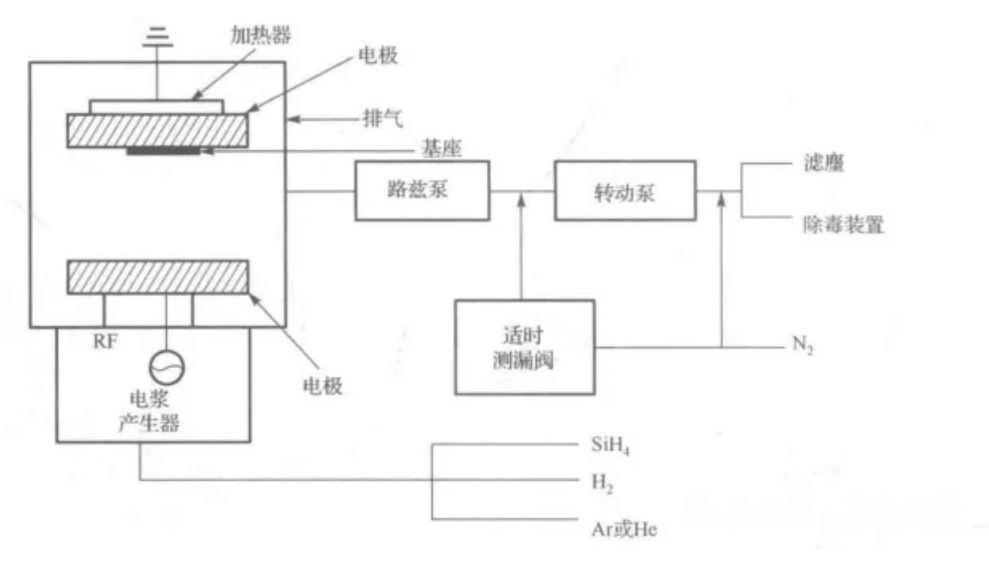
PECVD系统的结构示意图
| 