图下所示为由应用材料(AppliedMaterials)开发的另外一种PECVD 系统,是个承片台(Suspector)可以转动的PECVD系统。采用平板电极,通过射频源产生等离子体,等离子体将能量转移到反应气体,使反应气体可以在较低的温度下,在承片台上的衬底表面发生化学反应,从而形成所需要组分的薄膜。这种结构的PECVD系统,衬底放置在接地电极上,因此,可以尽可能地减少衬底表面受到高能量的离子轰击,因此,所形成的薄膜质量成分比较纯,薄膜厚度相对比较均匀。
PECVD以TEOS(Tetraethyl Orthosilicate 四乙基原硅酸盐)生长 Si0,时,内部掺入含有氟的物质就可以形成SiOF的低介电常数材料,此类材料非常符合ULSI的工艺要求。低介电常数的另外几种加工工艺包括旋转涂覆(SpinCoating)和气相沉积(VaporPhase Deposition),还可以加工聚对二甲苯(Parylene)、铁氟龙(Teflon)等。
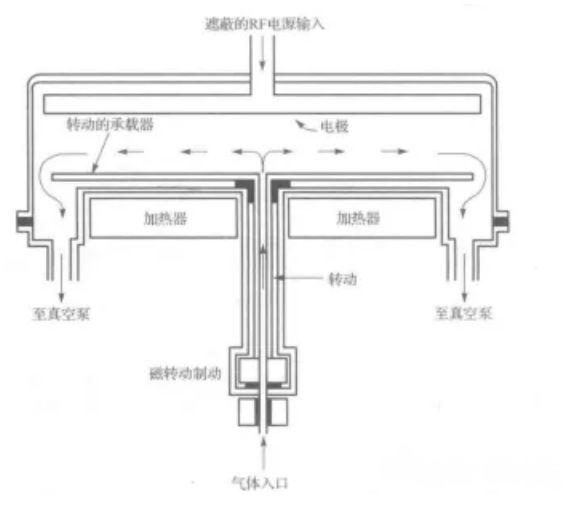
应用材料开发的承片台可以转动的PECVD系统示意图
在PECVD系统中,电源电极和接地电极的电位相对于等离子体大致是相等的。射频调节电路通常采用电感(Inductor),将电源电极旁路(Shunt)到接地电极。通过接
地可以阻止电源电极产生一个自我偏压,因此可以保持等离子体和电源及接地电极之间的电位差大致相等。平行板结构的PECVD系统的腔室采用石英、陶瓷或在金属壁上涂覆氧化铝,这样可以使腔室壁与等离子体之间维持一个漂浮电位。通过这种方式可以减少腔室壁受到轰击(Bombardment)和溅射(Sputtering),降低沉积薄膜的污染。PECVD系统采用较低的功率密度、较高的压力和较高的基座(承片台)温度(>200℃),这样可以使PECVD比溅射(Sputtering Deposition)遭受的辐射伤害比较小。因此,如果需要对辐射敏感的化合物半导体衬底进行薄膜沉积工艺,PECVD是一个比较好的选择。但是PECVD相比其他薄膜沉积工艺,存在薄膜化学成分比例不好的缺陷,在选择工艺时需要进行综合考虑。
在金属上进行SiO,或SiN。时,必须使用PECVD才能得到比较好的热稳定性。PECVD的其他优点是薄膜与衬底材料的粘附性比较好,针孔密度小,台阶覆盖率比较好,与精细线条转移工艺兼容性较好,比较适合VLSI工艺的应用。
除了以上介绍的一些常见的CVD工艺技术以外,近年来又发展了许多更加先进的CVD工艺技术。在这里进行简要介绍。
MOCVD(Metal Organic Chemical Vapor Deposition)是日常生产实践中经常使用的-种新型气相外延技术。这种技术是在气相外延(VaporPhaseEpitaxy,VPE)技术基础上发展起来的一种新型气相外延技术。MOCVD可以替代卤素气体单晶生产。MOCVD是以Ⅲ族、Ⅱ族元素的有机化合物和V、族元素的化物等作为品体生长源材料,以热分解反应方式在衬底上进行气相外延,生长各种Ш-V族、Ⅱ-V族化合物半导体
及它们的多元固溶体的薄层单晶材料。通常,MOCVD系统中的晶体生长都是在常压或低压(10~100Torr)下,在通H,的冷壁石英(不锈钢)反应室中进行的,衬底温度为500℃~1200℃,用射频感应加热石聚基座(衬底基片在石墨基座上方),H,通过温度可控的液体源鼓泡携带金属有机物到生长区。图7-22所示为一个MOCVD系统示意图。
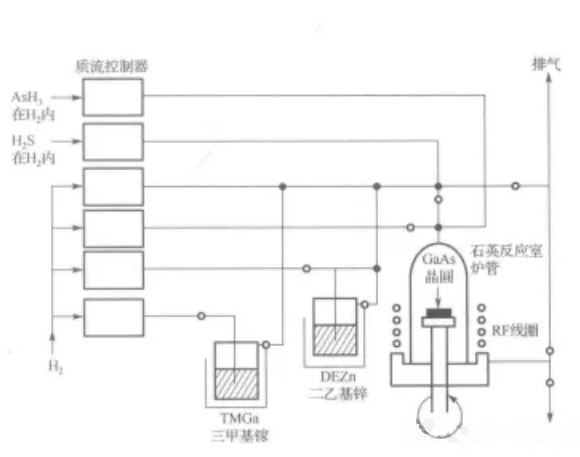
生长AIGaAs的MOCVD系统示意图
| 