一、清洗硅片(Wafer Clean)
清洗硅片的目的是去除污染物去除颗粒、减少针孔和其它缺陷,提高光刻胶黏附性
基本步骤:化学清洗——漂洗——烘干。
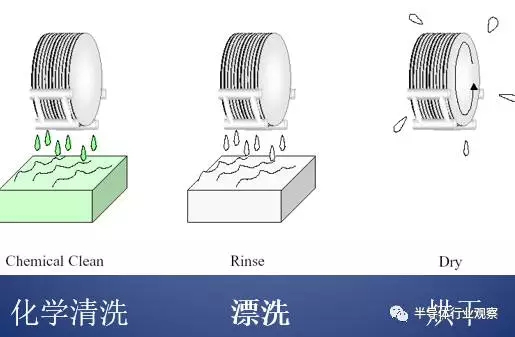
硅片经过不同工序加工后,其表面已受到严重沾污,一般讲硅片表面沾污大致可分在三类:
A. 有机杂质沾污: 可通过有机试剂的溶解作用,结合超声波清洗技术来去除。
B. 颗粒沾污:运用物理的方法可采机械擦洗或超声波清洗技术来去除粒径 ≥ 0.4 μm颗粒,利用兆声波可去除 ≥ 0.2 μm颗粒。
C. 金属离子沾污:必须采用化学的方法才能清洗其沾污,硅片表面金属杂质沾污有两大类:
a. 一类是沾污离子或原子通过吸附分散附着在硅片表面。
b. 另一类是带正电的金属离子得到电子后面附着(尤如“电镀”)到硅片表面。
硅抛光片的化学清洗目的就在于要去除这种沾污,一般可按下述办法进行清洗去除沾污。
a. 使用强氧化剂使“电镀”附着到硅表面的金属离子、氧化成金属,溶解在清洗液中或吸附在硅片表面。
b. 用无害的小直径强正离子(如H+)来替代吸附在硅片表面的金属离子,使之溶解于清洗液中。
c. 用大量去离水进行超声波清洗,以排除溶液中的金属离子。
自1970年美国RCA实验室提出的浸泡式RCA化学清洗工艺得到了广泛应用,1978年RCA实验室又推出兆声清洗工艺,近几年来以RCA清洗理论为基础的各种清洗技术不断被开发出来,例如:美国FSI公司推出离心喷淋式化学清洗技术、美国原CFM公司推出的Full-Flow systems封闭式溢流型清洗技术、美国VERTEQ公司推出的介于浸泡与封闭式之间的化学清洗技术(例Goldfinger Mach2清洗系统)、美国SSEC公司的双面檫洗技术(例M3304 DSS清洗系统)、 日本提出无药液的电介离子水清洗技术(用电介超纯离子水清洗)使抛光片表面洁净技术达到了新的水平、以HF / O3为基础的硅片化学清洗技术。
二、预烘和底胶涂覆(Pre-bake and Primer Vapor)
由于光刻胶中含有溶剂,所以对于涂好光刻胶的硅片需要在80度左右的。硅片脱水烘焙能去除圆片表面的潮气、增强光刻胶与表面的黏附性、通常大约100 °C。这是与底胶涂覆合并进行的。
底胶涂覆增强光刻胶(PR)和圆片表面的黏附性。广泛使用: (HMDS)六甲基二硅胺、在PR旋转涂覆前HMDS蒸气涂覆、PR涂覆前用冷却板冷却圆片。
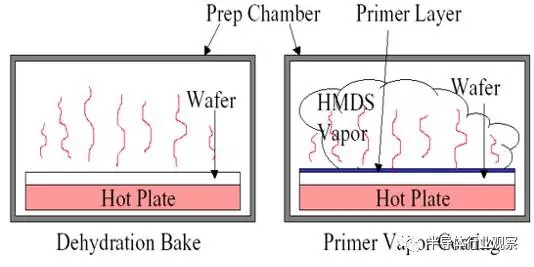
预烘和底胶蒸气涂覆
| 